GaN-Testplatine zur dynamischen Bewertung des On-Widerstands
Über den stabilen Betrieb von GaN-Leistungstransistoren entscheidet auch der dynamische Durchlasswiderstand RDS(on). Doch ist es nicht trivial, ihn mit ausreichender Auflösung konsistent zu messen.
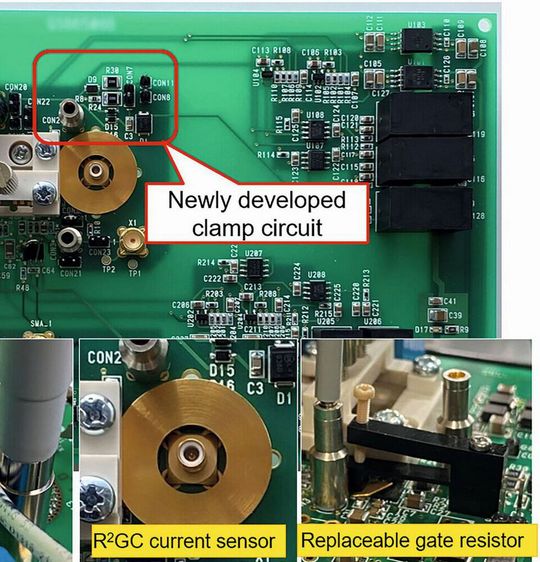
Das Potenzial der Galliumnitrid- Devices für leistungselektronische Systeme ist groß. Aber noch haben viele Entwickler Bedenken hinsichtlich der Zuverlässigkeit. Ein wesentliches Hauptproblem eines GaN-Leistungstransistors ist der Anstieg seines dynamischen Durchlasswiderstands (RDS(on)) während des Schaltvorgangs. Das Phänomen ist als Current Collapse bekannt. Current Collapse tritt nur bei GaN-Transistoren auf und ist das Ergebnis von Elektroneneinschlüssen in der Transistorstruktur, wenn eine hohe Drain-Ausschaltspannung angelegt wird. Der Artikel zeigt, wie mit einem Doppelpuls-Testsystem der Current Collapse von GaN-Leistungstransistoren effektiv bewerten werden kann.
Es dauert eine gewisse Zeit, bis die eingeschlossenen Elektronen während eines Einschaltvorgangs wieder freigesetzt werden, was durch die dynamische Messung von RDS(on) charakterisiert wird. Ein erhöhter dynamischer RDS(on) verschlechtert die Leitungsverluste der GaN-Leistungstransistoren und erhöht die Temperatur. Das wiederum wirkt sich auf die Zuverlässigkeit des GaN-Leistungstransistors und des Systems insgesamt aus. Einige Hersteller bieten sogenannte Collapse-freie GaN-Leistungstransistoren an. Doch die Auswirkungen eines solchen Current Collapse werden von Entwicklern weiterhin kritisch eingeschätzt. Daher müssen nicht nur die Hersteller der Bauelemente, sondern auch die Entwickler von Stromrichtern den dynamischen RDS(on) von GaN-Leistungstransistoren genau bewerten.
Messung des dynamischen Durchlasswiderstands
Dieser dynamische Durchlasswiderstand RDS(on) stellt Entwickler beim Messen immer wieder vor Probleme. Beispielsweise durch das Übersteuern und Begrenzen des dynamischen Bereichs von Oszilloskopen.
Bei der Messung des dynamischen Widerstandwerts sollte der Messbereich des Oszilloskops gerade groß genug sein, um die Drain-Spannung nur im eingeschalteten Zustand VDS(on) zu überwachen. Das kann beispielsweise bei 1 V/div sein. So erhält man die beste Auflösung des Oszilloskops. Leider schaltet der Transistor von einer hohen Drain-Aus-Spannung (VDS(off)) wie 400 V. Die Verstärker im Oszilloskop verzerren die Signalform, wenn der Messbereich nicht weit genug ist, um sowohl VDS(off) als auch VDS(on) abzudecken.
Diesen Vorgang bezeichnet man als Übersteuerung des Oszilloskops, der zu gesättigten Oszilloskopverstärkern und fehlerhaften Messungen bei VDS(on) führt. Daher muss man den Bereich des Oszilloskops weit genug einstellen, um sowohl VDS(off) als auch VDS(on) zu erfassen. Nur dann wird der Eingang nicht übersteuert.
Allerdings stößt man dann auf das Problem der Begrenzung des dynamischen Bereichs von Oszilloskopen. Selbst die High-End-Oszilloskope mit der höchsten vertikalen Auflösung haben nur etwa neun effektive Bit (ENOB) bei einer Bandbreite von 20 MHz. In den meisten Fällen ist ENOB der nützlichere Parameter als die reine Anzahl der Bits des A/D-Wandler im Oszilloskop. Oft liegen einige der Roh-Bit unter dem Rauschpegel des Verstärkers und sind damit unbrauchbar. Daher kann das Oszilloskop nur 1/29=1/512 des Skalenendwertes erkennen. Wenn VDS(off)=400 V beträgt, ist die Mindestauflösung 400/512=0,78 V, was für dynamische Messungen des RDS(on) völlig inakzeptabel ist.
Den Widerstandswert mittels GaN-Testplatine messen
Damit mögliche Probleme beim Testen von GaN-Leistungstransistoren nicht mehr auftreten, hat Messtechnik-Hersteller Keysight eine kundenspezifische GaN-Testplatine entwickelt, die sich mit dem Dynamic Power Device Analyzer und Doppelpulstester PD1500A verwenden lässt. Um speziell die Einschränkung des dynamischen Bereichs des Oszilloskops zu überwinden, hat Keysight auch eine Klemmschaltung entworfen. Bild 1 zeigt das angepasste GaN-Testboard. Die Klemmschaltung befindet sich in der Nähe der Schnittstelle des Prüflings. Das Board besitzt eine lötfreie Prüfling-Schnittstelle, einen Stromsensor mit niedriger Einfügeinduktivität und austauschbare Gate-Widerstände. Letztere werden als reproduzierbare und zuverlässige GaN-Charakterisierungstechniken, kurz R2GC für Repeatable and Reliable GaN Characterization, bezeichnet.
Bild 2 zeigt ein vereinfachtes Konzept der Klemmschaltung. Diese Schaltung wird parallel zum Ausgang des Prüflings geschaltet. Angenommen, die Spannungsschwelle (VTH) von Q1 beträgt 2 V. Wenn die Klemmspannung auf 8 V eingestellt ist, misst die Schaltung die Spannung VCLAMP bis zu 6 V genau, wenn VDS des Prüflings unter 6 V liegt. Wenn VDS jedoch über 6 V liegt, misst das System nicht mehr als 6 V. Das Oszilloskop lässt sich auf einen niedrigen Spannungsbereich wie 1 V/div einstellen, was eine ausreichende vertikale Auflösung für dynamische Messungen RDS(on) bietet. Diese Prüfmethode mit einer Klemmschaltung wird in der JEDEC-Veröffentlichung JEP173 vorgeschlagen.
Dynamischen RDS(on) genauer bewerten
Hersteller Keysight hat die Leistung des angepassten GaN-Testboards mit einem handelsüblichen GaN-E-HEMT (Enhancement Mode High Electron Mobility Transistor) für 650 V bewertet. Bild 3 zeigt die Einschalt-Signalformen des GaN-E-HEMT bei VDS(off) = 400 V, IDS(on) = 30 A. Die gelbe Signalform zeigt die geklemmte Drain-Spannung (VCLAMP) und die braune Linie zeigt RDS(on), berechnet durch VCLAMP/IDS und unter Verwendung einer Tiefpassfiltereinstellung von 20 MHz am Oszilloskop.
Die gelbe Signalform zeigt, dass die gemessene VDS bei etwa 4,5 V geklemmt ist und dass VDS(on) bei etwa 2 V gemessen wird. Das Spitze/Spitze-Rauschen des Werts RDS(on) betrug etwa 1 mOhm (30 mV in Bezug auf VDS(on)), was sehr viel genauer ist als die ursprüngliche VDS-Auflösung von 0,78 V. Das ist ausreichend, um den dynamischen RDS(on) für die meisten GaN-Leistungstransistoren zu bewerten.
Ein weiteres wichtiges Merkmal für die Klemmschaltung ist die Reaktionszeit der Schaltung. In typischen Anwendungen der Leistungselektronik, etwa bei DC/DC-Wandlern, wird die Schaltfrequenz der GaN-Leistungstransistoren immer schneller und liegt mittlerweile bei über 1 MHz. Dabei sollte die Ansprechzeit der Klemmschaltung weniger als ein paar hundert Nanosekunden betragen, um den dynamischen RDS(on) unter praktischen Betriebsbedingungen zu messen. Die Komponenten der Klemmschaltung wie Transistoren und Dioden haben physikalisch eine gewisse Sperrschichtkapazität und Erholungseigenschaften. Damit wird die Ansprechzeit der Schaltung beeinträchtigt. Das erschwert ein schnelles Ansprechen der Klemmschaltung.
Zurück zu Bild 3: Die geklemmte Signalform VDS (gelb) zeigt einen negativen Einbruch für etwa 50 ns direkt nach dem Einschaltvorgang. Der negative Einbruch ist auf die Auswirkungen der parasitären Effekte der Klemmschaltung zurückzuführen. Nach dem Einbruch zeigt das angeklemmte Signal VDS den korrekten Verlauf VDS(on). Die Ansprechzeit der Clamp-Schaltung im Doppelpulstest-System betrug weniger als 100 ns.
Ein Vergleich mit einem älteren Power Device Analyzer
Das dynamische Testverfahren RDS(on) haben die Entwickler von Keysight mit dem früheren System B1505A mit N1267A HVSMU/HCSMU-Schnellschalter verglichen. Bild 4 zeigt die Messergebnisse eines 100 V/10 mΩ-GaN-E-HEMT, die mit beiden Systemen erzielt wurden. B1505A basiert auf SMU-Technik und die Messung benötigt einige zehn Mikrosekunden zum Einschwingen. Die Klemmschaltung des PD1500A hat im Vergleich eine etwa 1000-mal schnellere Reaktionszeit und erkennt die schnelle Antwort des Current-Collapse-Verhaltens, das innerhalb von 100 ns nach dem Einschalten auftritt. Das Grundrauschen des gemessenen dynamischen RDS(on) ist etwa zehnmal kleiner als beim B1505A. Somit ist die Messung des dynamischen RDS(on) deutlich besser.
Um mehr über die Möglichkeiten des dynamischen RDS(on)-Tests zu erfahren, haben die Entwickler die Off-Pulslänge und die VDS(off)-Abhängigkeit des dynamischen RDS(on) für einen GaN-E-HEMT mit einer Nennspannung von 650 V untersucht. Allgemein steigt der dynamische RDS(on) von GaN-Leistungstransistoren mit Current Collapse bei einer längeren und höheren Belastung von VDS(off). Die Auswirkung des Current Collapse lässt sich durch den Vergleich des RDS(on) zwischen dem ersten und dem zweiten Puls der Signalform des Doppelpulstests erkennen.
Bild 5 zeigt das dynamische Verhalten RDS(on) des GaN-E-HEMT während des Doppelpulstests. Dabei wurde die Abweichung des RDS(on) (ΔRDS(on)) zwischen dem ersten Puls mit 100 ns vor dem Abschalten von VGS und dem zweiten Puls mit 100 ns nach dem Einschalten von VGS extrahiert. Wie in Bild 6 gezeigt, stieg ΔRDS(ON) leicht an, je länger und höher die Belastung mit VDS(off) war. Damit ist bestätigt, dass das Doppelpuls-Testsystem den Current Collapse von GaN-Leistungstransistoren effektiv bewerten kann.
* *Takamasa Arai, Ryo Takeda, Bernhard Holzinger, Michael Zimmerman und Mike Hawes ... die Autoren arbeiten bei Keysight Technologies.
Artikelfiles und Artikellinks
(ID:48187079)



:quality(80)/p7i.vogel.de/wcms/a2/17/a2178caf3536c79263548aa97f279fca/0117964712.jpeg)
:quality(80)/p7i.vogel.de/wcms/b9/2a/b92a285d338f26023fd731aee489dc73/0117749431.jpeg)
:quality(80)/p7i.vogel.de/wcms/91/24/91246f556a0dae465cb4bc031cfa2a20/0117649783.jpeg)
:quality(80)/p7i.vogel.de/wcms/b8/ee/b8eea1f815ad79e479f834bc9a72f117/0117585058.jpeg)
:quality(80)/p7i.vogel.de/wcms/40/34/40347aa12539d6b34265642af8eaf622/0117991894.jpeg)
:quality(80)/p7i.vogel.de/wcms/76/35/763517693c748cca8ee60d43fb47bda4/0117781759.jpeg)
:quality(80)/p7i.vogel.de/wcms/9a/65/9a6508c8b237d09299fe05e1319b6a22/0117513757.jpeg)
:quality(80)/p7i.vogel.de/wcms/a9/5c/a95c0e1752ebef4cb766f0d89cac119e/0117627842.jpeg)
:quality(80)/p7i.vogel.de/wcms/62/21/6221f81d893a4f2513db526269cbcea0/0117465562.jpeg)
:quality(80)/p7i.vogel.de/wcms/19/d9/19d9ddde8a155b02baafbdb362b0e277/0117128247.jpeg)
:quality(80)/p7i.vogel.de/wcms/61/83/6183434c7a03a2b142b27fe266d54be8/0117020595.jpeg)
:quality(80)/p7i.vogel.de/wcms/4a/c9/4ac9bc7da226394167c6358e64f19bbf/0117750565.jpeg)
:quality(80)/p7i.vogel.de/wcms/59/e6/59e64276f7c1a7d78f07d689b8ec1aad/0117042615.jpeg)
:quality(80)/p7i.vogel.de/wcms/43/ce/43ce51466a3eeeeb2a749dc28dec9250/0117619117.jpeg)
:quality(80)/p7i.vogel.de/wcms/87/c4/87c43cf12ce74247519ae05e9895c76b/0117445107.jpeg)
:quality(80)/p7i.vogel.de/wcms/bd/4d/bd4d83df8c07d0507948683f8afc0134/0116830678.jpeg)
:quality(80)/p7i.vogel.de/wcms/a4/14/a414ed31d001782a59b1ba5faa72d908/0104047588.jpeg)
:quality(80)/p7i.vogel.de/wcms/dc/67/dc67e95d37c1ed222b527d9c63945878/0104007518.jpeg)
:quality(80)/p7i.vogel.de/wcms/2c/ec/2cec3a960208e5429dfbce65a92f44b4/0104007527.jpeg)
:quality(80)/p7i.vogel.de/wcms/52/e2/52e28b1c718259946b4a09bc6b8207a0/0104007534.jpeg)
:quality(80)/p7i.vogel.de/wcms/88/ea/88ea9cf04f1f955e6222795861a94dd4/0114889866.jpeg)
:quality(80)/p7i.vogel.de/wcms/bd/4d/bd4d83df8c07d0507948683f8afc0134/0116830678.jpeg)